这两天不少网友都在热议工信部披露的新款国产氟化氩光刻机光刻机的消息,一时间,各种关于国产光刻机大突破言论满天飞,甚至还有人一看到“套刻≤8nm”就认为这是8nm光刻机,也是令人啼笑皆非。

其实,早在6月20日,工信部就曾发布了《首台(套)重大技术装备推广应用指导目录(2024年版)》公示,集成电路生产设备一栏当中,就有公示一款氟化氪光刻机和一款氟化氩光刻机。随后在9月9日,工信部又将该通知重发了一遍:


氟化氪光刻机其实就是老式的248nm光源的KrF光刻机,分辨率为≤110nm,套刻精度≤25nm;氟化氩光刻机则是193nm光源的ArF光刻机(也被成为DUV光刻机),但披露的这款依然是干式的DUV光刻机,而非更先进的浸没式DUV光刻机(也被称为ArFi光刻机)。
从官方披露的参数来看,该DUV光刻机分辨率为≤65nm,套刻精度≤8nm。虽然相比之前上微的SSA600光刻机有所提升(分辨率为90nm),但是仍并未达到可以生产28nm芯片的程度,更达不到制造什么8nm、7nm芯片的程度。很多网友直接把套刻精度跟光刻制造制程节点水平给搞混了。
光刻精度主要看的是光刻机的分辨率,65nm的分辨率,那么单次曝光能够达到的工艺制程节点大概就在65nm左右。
套刻精度则指的是每一层光刻层之间的对准精度。众所周知,芯片的制造过程,实际上是将很多层的光刻图案一层一层的实现,并堆堆叠而成。一层图案光刻完成后,需要再在上面继续进行下一层图案的光刻,而两层之间需要精准对准,这个对准的精度就是套刻精度,并不是指能够制造的芯片的工艺制程节点。
那么,这个65nm的光刻分辨率、套刻精度≤8nm能够做到多少纳米制程呢?又相当于目前ASML什么水平的光刻机呢?可以对比看下面的ASML光刻机的参数:
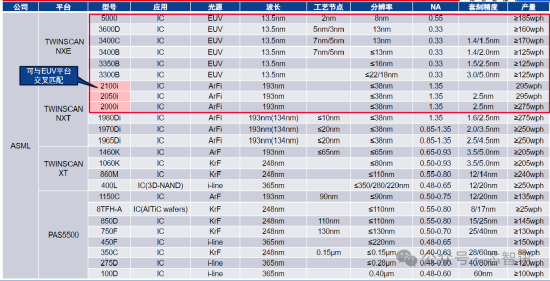
ASML于2015年二季度出货的TWINSCAN XT:1460K的光刻分辨率为≤65nm,但是套刻精度更高(<5nm)。虽然这款国产DUV光刻机的分辨率也是≤65nm,都可以做65nm制程甚至更先进一些芯片,但是由于该国产光刻机套刻精度误差更大,这也将导致其良率水平可能相对会低一些。
也就是说,该国产DUV光刻机的性能甚至要低于ASML九年前就已经出货的XT:1460K光刻机的水平。如果再往前看,其实ASML 2006年推出的干式DUV光刻机XT:1450的分辨率就已经达到了57nm,套刻精度为7nm。该国产DUV光刻机性能与ASML的技术实际差距超过18年。

虽说65nm的光刻分辨率采用多重曝光,有可能做到更先进的工艺节点,但是会受限于套刻精度所带来的误差叠加放大。
根据某光刻大厂的一位内部专家向芯智讯透露,65nm分辨率的ArF光刻机,配合好的OPC(光学邻近效应校正)算法,可以推进到55nm制程。
“单次曝光的overlay(套刻精度)的控制窗口是1/4至1/5的线宽,所以55nm线宽的芯片需要至少11nm的overlay才能够制造。虽然该光刻机的套刻精度为≤8nm,但这只是出厂标准,在晶圆加工过程中的各种工序本身还会带来误差,所在整个芯片制造上的overlay会比出厂标准更低,所以8nm的套刻精度实际落在产品上可能就差不多11-12nm了。所以单次曝光最多也就能做到55-65nm的水平。”
“如果采用多重曝光,比如双重曝光,那么所需要的overlay就要砍半,所以现有的单次曝光55nm水平,如果要做双重曝光,那么至少需要55÷5÷2=5.5nm的overlay,四重曝光overlay还要再砍一半,那就是需要2.75nm的overlay。因此,8nm的overlay是没有办法来做多重曝光的。”该光刻技术专家对芯智讯进一步解释道。
所以,总结来说,如果要做多重曝光,那么套刻精度就需要足够的高,换句话来说就是套刻的误差需要足够的小。
比如之前业界最早做28nm制程量产基本都是用了先进的ASML NXT:1970(浸没式DUV)来做的,该光刻机的分辨率达到了更高的≤38nm,套刻精度也达到了<3.5nm。
由于国产28nm制程量产时间相对较晚,后面都是用了更先进的ASML NXT:1980来做28nm量产,虽然其分辨率还是≤38nm,但是套刻精度进一步达到了<2.5nm,这也使晶圆制造商得可以通过该机型进行多重曝光,可以实现7nm制程的制造。比如台积电的第一代7nm制程,就是采用ASML NXT:1980经过多重曝光来做的。当然多重曝光会带来成本大幅提升。
这也是为什么美国和荷兰一开始把光刻机对华出口限制给卡到了NXT:1980以上,后面又把NXT:1970 和 NXT:1980这两款采用多重曝光能够实现先进制程能力光刻机对大陆具备先进制程能力的晶圆厂的出口给限制了。
总结来说,这次曝光的65nm分辨率的国产DUV光刻机,应该只是之前的90nm分辨率的国产光刻机的改良版,还只能用于55-65nm的成熟制程芯片制造需求,还远达不到大家期望的制造28nm制程芯片的要求。当然,相比之前最先进的90nm分辨率国产光刻机来说,新的65nm分辨率的国产光刻机至少是已经有了一定的进步。但是,我们依然需要清醒的认识到我们与国外先进水平之间的差距,不可盲目乐观。
对于国产光刻机厂商来说,从干式DUV转向浸没式DUV这一过程还是存在很多技术难题需要解决的。要知道在2010年代前后,ASML就是依靠浸没式DUV光刻机(2006年就推出了首台量产的浸入式DUV光刻机XT:1700i)打败了当时的光刻机两大巨头佳能和尼康,确立了霸主地位。




![[Cosplay][Ely]Emperor FGO ネロ写真-我淘网](https://www.wtao.vip/wp-content/uploads/2020/03/63550ec5dda17ab.jpg)
![[Cosplay]木绵绵OwO – 背心黑丝居家写真-我淘网](https://www.wtao.vip/wp-content/uploads/2019/09/ce0885ed7082570-200x300.jpg)
![[图说]【喷嚏图卦20240903】未来很明了啊,早晚要完蛋的-我淘网](https://www.wtao.vip/wp-content/uploads/replace/dc2671ae964bdc929eb032592425c9e2.jpeg)
![[QingDouKe]青豆客 2017-02-25 莫雅淇-我淘网](https://www.wtao.vip/wp-content/uploads/2019/09/942eba15ccadb41-200x300.jpg)
![[图说]【喷嚏图卦20230820】以前大学都是随便进出的-我淘网](https://www.wtao.vip/wp-content/uploads/replace/3934711fb91a45b7f8068916600a35fa.jpeg)

暂无评论内容